Opis
Spektroskopia głębokich poziomów defektowych (DLTS) polega na badaniu zjawiska relaksacji pojemności diody półprzewodnikowej w następstwie jej pobudzenia impulsem napięciowym. Pomiar kinetyki pojemności złącza jest prowadzony w trakcie monotonicznej zmiany temperatury. W jego wyniku otrzymuje się widmo DLTS, jako serię pików związanych z poszczególnymi poziomami pułapkowymi. Cyfrowy wariant metody – Laplace DLTS, pozwala dzięki wykorzystaniu odwrotnej transformaty Laplace’a badanego sygnału odseparować i analizować wkłady od defektów o podobnej energii aktywacji i pochodzeniu, co w klasycznej technice DLTS nie jest możliwe.
Parametry
- Optyczny kriostat azotowy lub helowy wraz z chłodziarką helową;
- Kontroler temperatury LakeShore332 ;
- Cyfrowy miernik pojemności Boonton7200 z częstością próbkującą f = 1MHz.
- Rozmiar próbki (max.) 2mm*2mm
Zastosowania
Za pomocą techniki DLTS oraz jej wariantów możliwe jest określenie energii aktywacji centrum defektowego, koncentracji pułapek oraz wyznaczenie przekroju czynnego na wychwyt nośników. Z uwagi na prostotę znalazła ona zatem szerokie zastosowanie jako metoda badania defektów w półprzewodnikach. Opis struktury defektowej półprzewodników pozwala zaś projektować na ich bazie zaawansowane układy o pożądanych parametrach elektrycznych oraz optycznych.

Układ do pomiarów DLTS dostępny w laboratorium. |

Przykładowe widmo DLTS struktury Si-Au w zakresie temperatur 100 K – 320 K. |
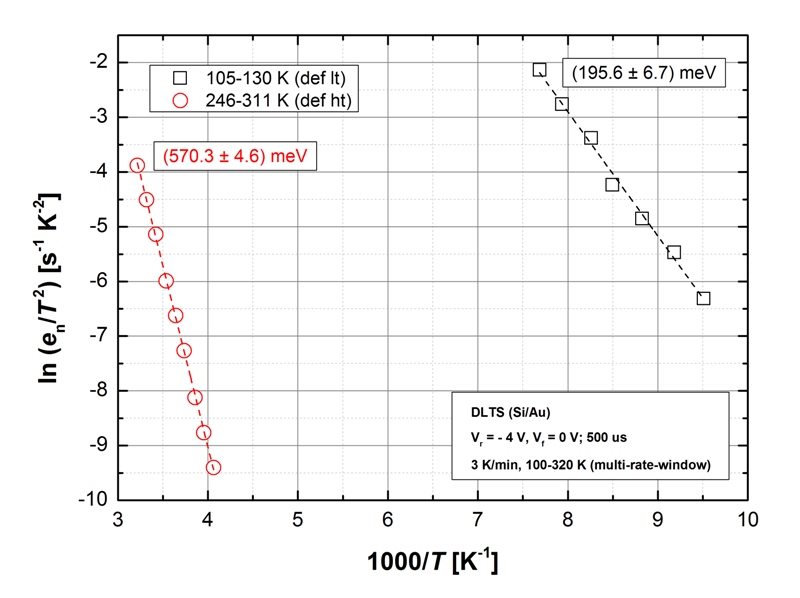
Wykresy Arrheniusa dla poziomów defektowych złącza Si-Au w zakresie temperatur 100 K – 320 K wraz z oszacowaną energią aktywacji. Analizy dokonano przy użyciu metody Laplace DLTS. |
prof. Leszek Sirko, e-mail: director@ifpan.edu.pl, tel: + 48 22 116 2111
Instytut Fizyki Polskiej Akademii Nauk, Aleja Lotników 32/46, 02-668 Warszawa
tel.: (+48) 22 843 70 01 | fax: (+48) 22 843 09 26 | www.ifpan.edu.pl
NIP: 525-000-92-75, Regon: 000326061
