Opis
Laboratorium jest międzyinstytutową jednostką składającą się z grup badawczych z Instytutu Technologii Elektronowej i Instytutu Fizyki. Jest wyposażone w nowy akcelerator NEC 3SDH-2 Pelletron typu tandem i Spektrometr Masowy Jonów Wtórnych Cameca IMS 6F (SIMS). Mamy również bezpośredni dostęp do innych uzupełniających technik analitycznych, takich jak SEM, TEM, AFM, XRD itp.
Parametry
- implantacja z energiami do 3 MeV
- implantacja wszystkich jonów aż do uranu (z wyjątkiem gazów szlachetnych cięższych od helu)
- analiza SIMS praktycznie wszystkich pierwiastków
- granice wykrywalności w pomiarach SIMS od 1012 do 1016 ion/cm3
Zastosowania
Pomiary RBS pozwalają określić skład i stechiometrię cienkich warstw. Pierwotna wiązka He++ może być przyspieszana do energii do 3 MeV. Pomiary kanałowania (RBS/c) są wykorzystywane do oceny populacji defektów w materiałach krystalicznych. Implantator akceleratorowy może produkować wiele różnych jonów o energiach od ≈200 keV do 3 MeV. To umożliwia modyfikację właściwości próbek stałych i wprowadzanie obcych atomów, do głębokości kilku mikrometrów dla lekkich pierwiastków. Należy zauważyć, że energia jonów w konwencjonalnych implantatorach jest ograniczona do ≈250 keV. Ostatnie badania prowadzone w laboratorium dotyczą mobilności wodoru implantowanego do węglika krzemu. Spektrometria masowa jonów wtórnych szczególnie nadaje się do wykrywania i profilowania zarówno domieszek jak też zanieczyszczeń o skrajnie niskich stężeniach. Obszar zainteresowań obejmuje szeroki zakres materiałów od półprzewodników do metali. Rozdzielczość głębokościowa profilowania SIMS jest korzystna do mierzenia struktur warstwowych. Laboratorium specjalizuje się w wykrywaniu i określaniu skrajnie niskich zawartości pierwiastków tzw. "atmosferycznych " takich jak H, C, N i O. Jest to możliwe, ponieważ komora analityczna jest wyposażona w pompę jonową zamiast powszechnie instalowanych pomp turbomolekularnych.

Akcelerator NEC 3SDH-2 Pelletron typu tandem. |
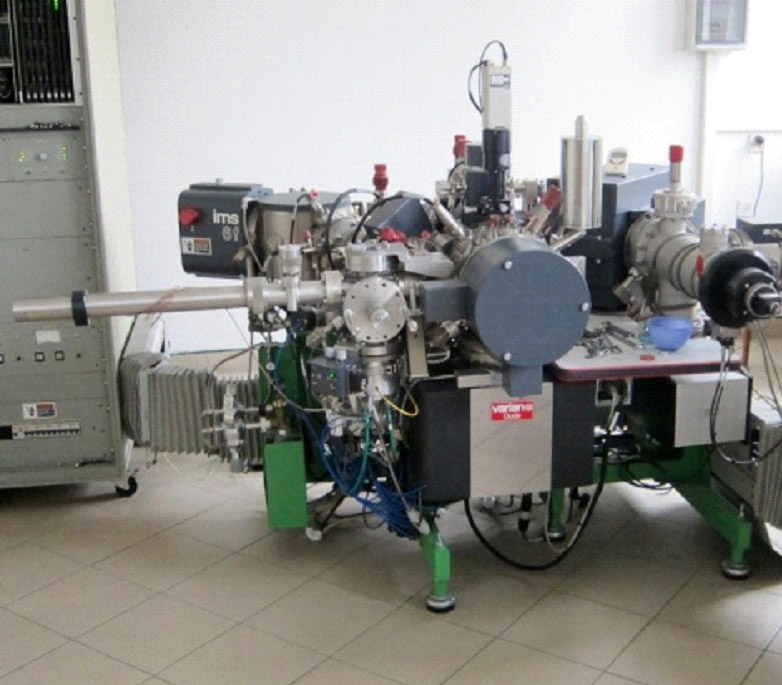
Spektrometr Masowy Jonów Wtórnych Cameca IMS 6F (SIMS). |
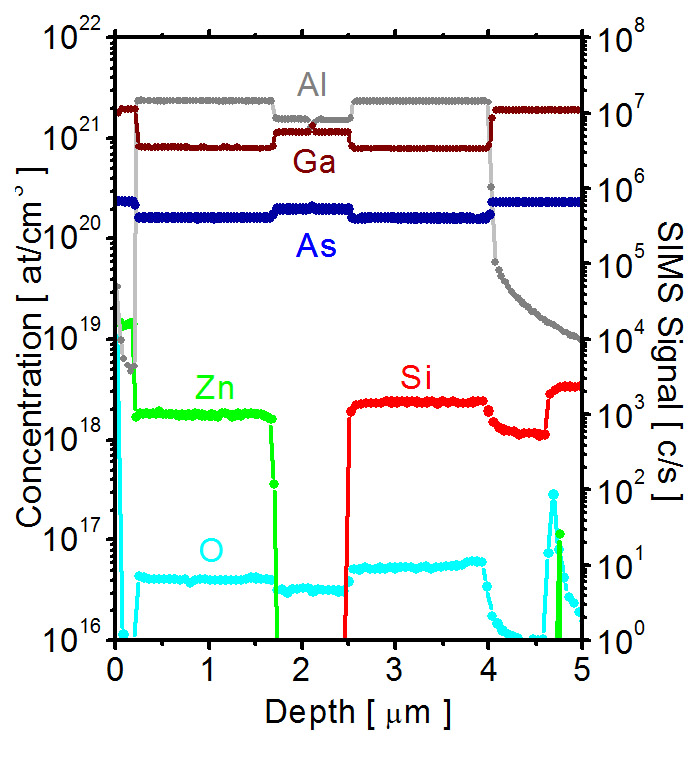
Profil głębokościowy SIMS z oznaczeniem składu struktury laserowej GaAs/AlGaAs oraz atomów domieszek. |
prof. Leszek Sirko, e-mail: director@ifpan.edu.pl, tel: + 48 22 116 2111
Instytut Fizyki Polskiej Akademii Nauk, Aleja Lotników 32/46, 02-668 Warszawa
tel.: (+48) 22 843 70 01 | fax: (+48) 22 843 09 26 | www.ifpan.edu.pl
NIP: 525-000-92-75, Regon: 000326061
